産業技術総合研究所・集積マイクロシステム研究センター・ライフインターフェース研究チーム主任研究員の小林健氏,大日本印刷・研究開発センター・次世代MEMS研究所の森脇政仁氏,瓜生敏文氏らの研究グループは,圧電薄膜であるチタン酸ジルコン酸鉛(Pb(Zr,Ti)O3,PZT)薄膜を用いた圧電MEMSデバイスの200mmウェハプロセス技術を開発した。

(a)従来の条件で形成したPZT薄膜、(b)今回開発した条件で形成したPZT薄膜(粗大粒子をウエハーあたり20個以下に低減)、(c)PZT薄膜を形成した200 mmウエハーの全体像、(d)圧電MEMSデバイスの200 mmウエハープロセス技術により作製した圧電MEMSデバイス。
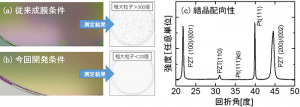
(a)と(b)の矢印の先の青点は、ウエハー表面検査装置で測定した粗大粒子分布測定結果。(c)のPt(111)は下地電極に由来する回折ピーク。
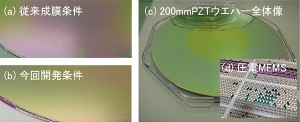
PZT薄膜を用いた圧電MEMSデバイスはインクジェットヘッド,ジャイロセンサーを中心に100 mm,150 mmウエハープロセスで製造されている。しかし,PZT薄膜形成の難しさから200 mmウエハープロセス化が進まず,低コスト化の障壁となっていた。
今回,200 mmウエハーにPZT薄膜を形成できる自動ゾルゲル形成装置を開発するとともに,歩留まり低下の原因となる粗大粒子の生成をウエハーあたり20個以下に抑制できる薄膜形成条件を見いだした。また,産総研が保有するMEMS製造ラインを用いて,圧電MEMSデバイスの200 mmウエハープロセス技術を確立した。圧電MEMSデバイス作製後に直流電圧を加えるポーリングをすることで,d31=-90 pm/V(-2~+2 V駆動時)と実用レベルの圧電定数を実現した。
詳細はこちら。
































